当台积电CoWoS产能因英伟达订单暴增而供不应求时,国内半导体产业正悄然酝酿一场变革。开源证券最新研报指出,国产类CoWoS封装技术已进入高速发展期,有望在AI芯片封装领域实现弯道超车。
技术路径与产业布局
台积电CoWoS-S采用硅中介层,可封装8个HBM3芯片,但良率与成本问题制约其普及。国内厂商则另辟蹊径:
中介层创新:通过RDL(再分布层)技术替代硅中介层,降低材料成本30%以上;
3D封装突破:长电科技推出的SoIC技术,已实现12层芯片堆叠,性能较传统封装提升40%;
产能扩张:日月光、通富微电等企业加速布局2.5D/3D封装产线,预计2026年国内先进封装产能将占全球20%。
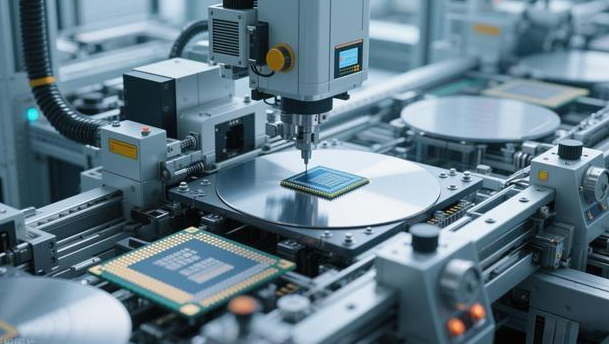
应用场景与市场前景
AI芯片对算力与内存的需求,为先进封装带来广阔空间。Yole预测,2023-2029年全球2.5D/3D封装市场年复合增长率将达30.5%,其中数据中心、自动驾驶、高端消费电子是主要驱动力。国内厂商正通过“技术授权+联合研发”模式,与寒武纪、华为海思等企业深度绑定,构建自主可控的供应链体系。
版权声明
本文仅代表作者观点,不代表百度立场。
本文系作者授权百度百家发表,未经许可,不得转载。











